产品资讯
大功率白光LED封装技术
随着照明技术的发展,大功率白光LED将是未来照明的核心。白光LED 作为新型光源,与传统光源相比具有寿命长、体积小、节能、高效、响应速度快、抗震、无污染等优点,被认为是可以进入普通照明领域的“绿色照明光源”,尤其是大功率白光LED 的诞生被业界称为“照明领域的第四次革命”,LED 大规模应用于普通照明是一个必然的趋势[1 ~ 3]。
LED 的产业链总体分为上、中、下游,分别是LED 外延片、LED 封装、LED 产品应用。其中关于LED 封装,特别是大功率LED 封装不能再按照传统的设计理念与生产模式( 传统的大功率LED 封装技术存在着一些不足,如散热问题、光取出方式等等) [4 ~ 6]。大功率LED 封装不仅结构和工艺复杂,而且对封装材料有一定的要求,因此,当前需要对传统的封装工艺进行研究。现在我们所面临的挑战:寻找导热性能优良的封装材料; 优化封装结构; 改进封装工艺。
随着照明技术的发展,为了满足普通照明的要求,大功率芯片随之诞生,这就对LED 封装的热学、电学、机械提出了更高要求,传统的小功率LED 封装结构和工艺难以满足要求。
2 大功率LED 封装的关键技术
相对于普通白光LED,大功率LED 芯片具有较大的热流率会产生大量的热量。研究发现,LED 器件的光通量与芯片的取光方式和出光效率的封装设计有关,因此LED 封装方式将会向以下的几个方向发展。
2. 1 低热阻封装工艺
传统的照明对散热问题要求不高,白炽灯、荧光灯可以通过辐射的方式进行散热。白光LED 以热传导为主进行散热,LED 是由固体半导体芯片作为发光材料,采用电致发光,所以其热量仅有极少部分通过辐射散发出[7]。对现有的LED 器件而言,输入电能的80%左右转变成热能,所以芯片散热管理对LED 封装意义重大。芯片散热管理主要包括芯片的位置、封装材料( 散热板、热界面材料) 、封装结构( 如热学界面) 还有热沉设计等。
LED 封装两大主要热阻内部热阻和界面热阻,热阻的封装材料散热板。芯片所产生的热量被散热板所吸收,并传到热沉上,通过热沉实现与外界进行热交换。常见的LED 散热板的类型有:( 1) 高散热金属板: 拥有高热导性、高耐热性、电磁等优点。不过,金属板其缺点是金属热膨胀系数很大。( 2) 陶瓷板散热性更好,且耐高温,耐潮湿等优点,但是由于价格是普通板的数倍,所以至今还没能成为散热型板的理想材料。( 3) 高热传导可绕板与传统的可绕板相同,唯独在绝缘层方面,采用软质环氧树脂充填高热传导性无机物,具有柔软可绕,高可靠性的优点[8]。以上板的热导率如表1 所示:
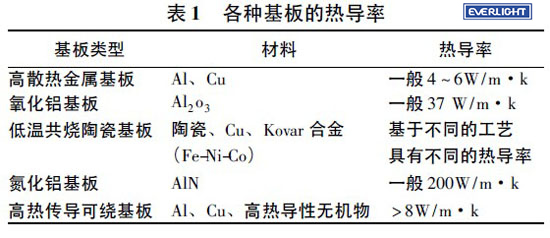
2. 2 倒装芯片封装技术
传统的LED 采用正装结构,上面通常涂敷一层环氧树脂,下面采用蓝宝石为衬底。在传统的正装LED 芯片封装方式中,由于P 型GaN 掺杂非常困难,现在大多数采用的方法是在P 型GaN 上制备金属透明电极( 见图1) ,使电流稳定扩散,达到均匀发光的目的。这种正装结构的PN 结是通过蓝宝石衬底来进行散热,由于环氧树脂导热能力很差,蓝宝石又是热的不良导体,热阻大,导致热量传导不出去,从而影响各个器件的正常工作。
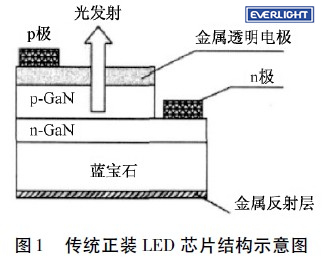
为了克服传统正装LED 芯片的缺陷,采用了先进的倒装芯片( flip chip) 技术,是在芯片的P 极和N 极下方用金线焊线机制作两个金丝球焊点( 如图2) ,作为电极的引出机构,用金线来连接芯片外侧和Si 底板。这就克服正装芯片出光效率和电流问题的弊端。从芯片PN 极上的热量通过金丝球焊点传到Si 热沉,Si 是散热的良导体,其散热效果远好于靠蓝宝石来散热。利用倒装芯片封装技术不但提高了LED 的寿命,而且使LED 整体散热性能有了一次飞跃。
2. 3 热学封装技术
能否成功地解决散热问题对大功率白光LED 的发光效率和可靠性有很大的影响。对于单颗LED 来说,热量全部来自于芯片,而芯片的尺寸很小热量不能及时的散发出去,会加速芯片和荧光粉的老化,还可导致倒装焊的焊锡融化,使芯片失效。当温度超过一定值,器件的的失效率呈指数规律变化,数据显示: 元器件温度每上升2℃,可靠性降低10%。为了保证器件的寿命,一般要求PN 极的温度在110℃以下,因此芯片散热是LED 封装必须解决的问题[11]。解决热的问题有两种办法: 一是提高芯片内量子效率,即提高芯片的发光效率,从根本上减少热量的产生; 二是LED 结构的改进,使内部的热量加快散发,有效地降低芯片的温度[12]。
封装界面对热阻的影响也是很大的,若不正确处理界面,难于获得良好的散热效果。改善LED 封装的关键界面间的空隙,增强散热。所以选择芯片和散热板的材料十分重要,LED 常用的封装材料为导热胶,导热率很低,使界面热阻很高。采用低温的锡膏作为热界面材料,界面热阻大大地降低了。为了取得更好的散热效果,引入了新的固晶工艺,即共晶焊接技术,以Si 片焊接作为热沉与晶粒之间的连接材料( 结构如图3) 其散热效果与物理特性远好于以往使用的Ag 胶( Ag 胶的热阻高,采用Ag 胶就等于人为地在芯片和热沉之间加上一层热阻) ,取得了良好的导热效果。
3 封装技术的发展方向
LED 封装技术主要是向高可靠性、高发光效率、高散热能力与薄型化发展。从芯片来看,水平式芯片最为普遍,垂直式芯片与覆晶型芯片是由一些比较有实力的厂家进行研发,水平式LED 使用蓝宝石作为板,其散热性能较差,光取出效率下降幅度较大,在高电流驱动下。垂直式芯片使发光层的材料得以充分应用,电流密度增大,LED 电阻降低,热量减少,大功率白光LED 倒装芯片的电流分布的均匀性和散热能力得到提升,从而有效改善倒装芯片的质量和性能。大功率白光LED 的封装主流方向如下:
3. 1 COB 封装技术
COB 封装是指直接在电路板上黏贴裸外延片,并将导线直接焊接在PCB 的镀金线路上,再通过封胶技术,将IC 制造过程中的封装步骤转移到电路板上直接组装。COB 的优点在于: 线路设计简单、高成本效益、节省系统空间等,但存在着芯片整合亮度、色温调和与系统整合的技术问题。
MCOB 技术好,能够有效提高产品的稳定性,更重要的是降低成本,所以MCOB 技术将是LED 行业的一种主流的封装形式。这是一项础性技术,MCOB 可以有效提高产品效率。中科院提供了关键技术,成功地解决了MCOB 成本和散热问题,即磁控建设技术有效地提高了反射率。于这种技术,是将材和芯片的直接接触,散热结构只有一层,散热片上的热量可以直接传到板上。由于MCOB 封装的芯片可以大大降低成本,所以可以认为在不久的将来LED 照明的成本可以做到比节能灯高一点或者持平。
3. 2 高电压直流芯片封装
正装结构的高电压LED 芯片: 把一个芯片的外延层分割成数个芯片单元,并把它们串联起来,则构成高电压芯片。晶元推出正装结构的高电压直流芯片,其中红光芯片HF27A 的电压为34 伏,效率达到128 lm/W,白光达到135 lm/W ( 5000k) 。
3. 3 无金线封装
晶科电子最新推出的陶瓷光源产品系列,该产品采用倒装焊技术产品于APT 专利技术,实现了单芯片及多芯片模组的无金线、无固晶胶封装,具有高亮度、高光效、高可靠性、低热阻、颜色一致性好等特点。
4 结语
封装技术关键在于优良的封装结构、良好的散热性能、低热阻和低机械应力。照明白光LED 受多重因素的影响,其中色度稳定性和均匀性、散热条件对LED 的性能影响比较大。LED 封装设计需要对光学、热学、电学、结构等方面进行综合的考虑,使这几个方面相互达到平衡,以达到最佳效果。大功率白光LED 封装只有通过不断地采用新工艺、新材料、新思路才能得以发展。

